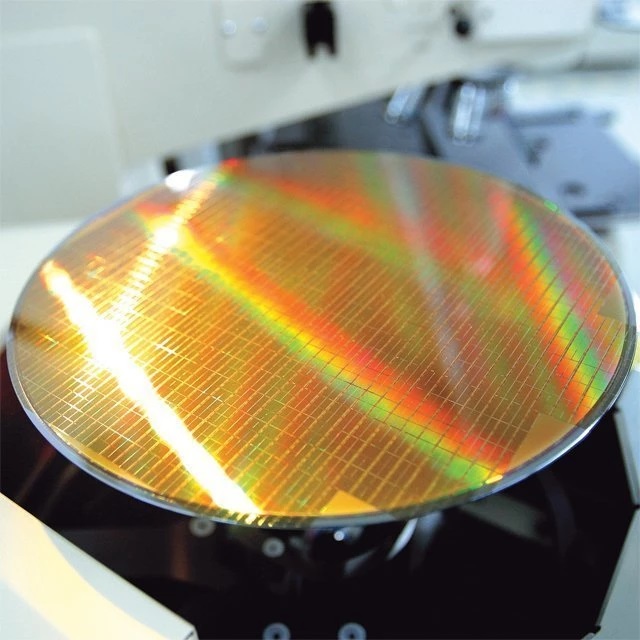
دیسپرس اولتراسونیک عوامل پولیشدهنده (CMP):
اندازه غیر یکنواخت ذرات و توزیع غیر همگن اندازه ذرات میتواند در طول فرآیندCMP باعث آسیب شدید به سطح پولیششده شود. پراکندگی اولتراسونیک یک روش پیشرفته برای پراکنده کردن و جدا کردن ذرات پولیش با اندازه نانو است. پراکندگی یکنواختی که با سونیکاسیون ایجاد میشود، باعث میشود فرآیند CMP روی سطوح با کیفیت بالاتری انجام شود و از ایجاد خراش یا نقص ناشی از دانههای بزرگ جلوگیری گردد.
سوسپانسیونهای پولیش شیمیایی-مکانیکی شامل ذرات ساینده نانو هستند تا خواص پولیش مطلوب را فراهم کنند. ذرات نانو معمولاً شامل دیاکسید سیلیکون، اکسید سریم، اکسید آلومینیوم، اکسید آهن و نانو الماسها و دیگر ذرات مشابه هستند.
برای جلوگیری از آسیب به سطح پولیششده، ذرات ساینده باید شکل یکنواخت و توزیع اندازه دانه محدود و مشخص داشته باشند. اندازه متوسط ذرات معمولاً بین ۱۰ تا ۱۰۰ نانومتر است و بسته به فرمولاسیون CMP و کاربرد آن متفاوت است.
فرایند دیسپرس التراسونیک به خوبی شناخته شده است که میتواند پراکندگیهای یکنواخت و پایدار در طولانیمدت ایجاد کند. کاویتاسیون و نیروهای برشی اولتراسونیک انرژی لازم را به سوسپانسیون منتقل میکنند تا ذرات تجمعیافته شکسته شوند، بر نیروهای واندروالس غلبه شود و ذرات ساینده به صورت یکنواخت در مایع پخش گردند.
با استفاده از سونیکاسیون، امکان کاهش اندازه ذرات دقیقاً به اندازه دانه هدفگذاریشده وجود دارد. با پردازش یکنواخت التراسونیک سوسپانسیون، دانههای بزرگ و توزیع نامتوازن اندازه ذرات حذف میشوند و نرخ حذف CMP مطلوب با کمترین میزان خراش تضمین میگردد.
مزایای دیسپرس اولتراسونیک CMP:
اندازه ذرات هدفمند
یکنواختی بالا
غلظت جامد از کم تا زیاد
اطمینانپذیری بالا
کنترل دقیق
تکرارپذیری دقیق
مقیاسپذیری خطی و بدون مشکل
فرمولبندی اولتراسونیک CMP
میکس و ترکیب اولتراسونیک:
در بسیاری از صنایع برای تولید سوسپانسیونهای پایدار با ویسکوزیتههای کم تا بسیار زیاد استفاده میشود. برای تهیه سوسپانسیونهای CMP یکنواخت و پایدار، مواد ساینده (مثل نانوذرات سیلیکا، سریم، α- و γ-Fe2O3 و غیره)، افزودنیها و مواد شیمیایی (مانند مواد قلیایی، ضدزنگها و تثبیتکنندهها) در مایع پایه (مثلاً آب تصفیهشده) به خوبی پراکنده میشوند.
از نظر کیفیت، برای سوسپانسیونهای پولیش با عملکرد بالا، ضروری است که سوسپانسیون پایداری طولانیمدت داشته باشد و توزیع ذرات به شکل بسیار یکنواخت انجام شود. پراکندگی و فرمولبندی اولتراسونیک انرژی لازم را برای جدا کردن ذرات تجمعیافته و توزیع یکنواخت ذرات ساینده فراهم میکند. کنترل دقیق پارامترهای پردازش التراسونیک باعث میشود نتایج با کارایی بالا و اطمینانپذیری کامل به دست آید.
پراکندگی اولتراسونیک برای توزیع ذرات ساینده در سوسپانسیونهای CMP بسیار مؤثر است. دستگاه LUP400 برای تولید سوسپانسیونهای CMP در آزمایشگاه استفاده میشود.

استفاده از تکنولوژی فراصوت برای تولید ذرات نانوی اکسید سریم
سیستمهای دیسپرس التراسونیک:
شرکت آواپرداز سیستمهای اولتراسونیک با توان بالا برای پراکندگی مواد نانو مانند سیلیکا، سریم، آلومینا و نانو الماسها ارائه میدهد. سیستمهای اولتراسونیک با اطمینان بالا، انرژی لازم را تأمین میکنند، راکتورهای اولتراسونیک پیشرفته شرایط بهینه فرآیند را ایجاد میکنند و اپراتور میتواند تمام پارامترها را به صورت دقیق کنترل کند. بنابراین نتایج فرآیند اولتراسونیک میتواند دقیقاً مطابق با اهداف مورد نظر (مانند اندازه دانه، توزیع ذرات و غیره) تنظیم شود.
یکی از مهمترین پارامترهای فرآیند دامنه اولتراسونیک است. سیستمهای صنعتی آواپرداز میتوانند دامنههای بسیار بالا را با اطمینان تأمین کنند. دامنههایی تا ۲۰۰ میکرومتر میتوانند به راحتی و به طور پیوسته در عملیات ۲۴/۷ اجرا شوند. توانایی اجرای چنین دامنههای بالا تضمین میکند که حتی اهداف فرآیندی بسیار پیچیده نیز قابل دستیابی باشند.
تمام پردازندههای اولتراسونیک ما میتوانند دقیقاً مطابق با شرایط فرآیند تنظیم شوند و از طریق نرمافزار داخلی به آسانی نظارت و کنترل شوند. این ویژگی باعث میشود بالاترین اطمینانپذیری، کیفیت پایدار و نتایج قابل تکرار تضمین گردد. همچنین استحکام تجهیزات اولتراسونیک آواپرداز امکان عملکرد بهصورت پیوسته و تماموقت حتی در شرایط سخت و محیطهای دشوار را فراهم میکند.
پولیش شیمیایی-مکانیکی (CMP):
سوسپانسیونهای پولیش/هموارسازی شیمیایی-مکانیکی (CMP) برای صاف کردن سطوح استفاده میشوند. این سوسپانسیونها از دو بخش اصلی تشکیل شدهاند: مواد شیمیایی و ذرات ساینده مکانیکی. به این ترتیب،CMP یک روش ترکیبی از حذف شیمیایی (etching) و پولیش ساینده است.
سوسپانسیونهای CMP به طور گسترده برای صاف کردن و پولیش کردن سطوح اکسید سیلیکون، پلیسیلیکون و فلزات استفاده میشوند. در طول فرآیند CMP، ناهمواریهای سطح از روی ویفر حذف میشوند (مثلاً در نیمههادیها، ویفرهای خورشیدی و قطعات دستگاههای الکترونیکی).
مواد فعال سطحی (Surfactants)
برای دستیابی به فرمول CMP پایدار در طولانیمدت، مواد فعال سطحی به سوسپانسیون اضافه میشوند تا نانوذرات در حالت پراکنده و یکنواخت باقی بمانند. این عوامل پراکنده میتوانند کاتیونی، آنیونی یا غیر یونی باشند و شامل موارد زیر هستند:
سدیم دودسیل سولفات (SDS)
ستیل پیریدینیوم کلراید (CPC)
نمک سدیم اسید کاپریک
نمک سدیم اسید لوریک
دسیل سدیم سولفات
هگزادسیل سدیم سولفات
هگزادسیلتریمتیلآمونیوم برمید (C16TAB)
دودسیلتریمتیلآمونیوم برمید (C12TAB)
تریتون X-100
تویین 20، تویین 40، تویین 60، تویین 80
سیمپرونیک A4،A7 ،A11 و A20














